
俆亅俆丏俽俻倀俬俢傊偺墳梡
丂
丂係亅俆愡偵偍偄偰丄廤懇僀僆儞價乕儉捈愙忲拝朄偵傛傝幚梡偵懌傞俶倐挻揱摫敄枌偺惉枌傪偍偙側偆偙偲偑壜擻偱偁傞偙偲傪弎傋偨丅杮愡偱偼丄俶倐挻揱摫敄枌傪梡偄偰旕慄宍婡擻慺巕偱偁傞僕儑僙僼僜儞愙崌乮Josephson junction乯傪嶌惢偟丄偝傜偵偦偺僕儑僙僼僜儞愙崌傪梡偄偰挻崅姶搙偺帴婥僙儞僒乕偱偁傞俽俻倀俬俢傪嶌惢偟丄偦偺摦嶌妋擣傪偍偙側偭偨偙偲偵偮偄偰弎傋傞丅
丂僕儑僙僼僜儞愙崌偵偼丄戝偒偔暘偗偰僩儞僱儖宆愙崌偲庛寢崌宆愙崌偺擇偮偺宍幃偑偁傞俇乯丅僩儞僱儖宆偼岤偝侾乣俀値倣掱搙偺嬥懏巁壔憌偐傜側傞愨墢枌傪擇偮偺挻揱摫懱偱偼偝傫偩峔憿傪偟偰偄傞丅愨墢憌偺岤傒偲偦偺嬒堦惈偑摿惈傪戝偒偔嵍塃偡傞丅堦曽丄庛寢崌宆偵偼偄偔偮偐偺峔憿偑偁傞偑丄偦偺戙昞揑側傕偺偼儅僀僋儘僽儕僢僕宆偲屇偽傟擇偮偺挻揱摫懱偑旝彫側挻揱摫懱乮儅僀僋儘僽儕僢僕偲屇偽傟傞庛寢崌晹暘乯偵傛傝愙懕偝傟偨峔憿傪傕偮丅儅僀僋儘僽儕僢僕晹偼偦偺梫媮偝傟傞戝偒偝乮偨偲偊偽挿偝偼係侽値倣埲壓偑惈擻偺椙偄庛寢崌偺偨傔偵梫媮偝傟傞乯偑儕僜僌儔僼傿乕偵傛傝壛岺偑壜擻側斖埻傛傝傕彫偝偄偨傔偵丄偄偐偵偦偺傛偆側旝嵶宍忬傪嵞尰惈椙偔嶌惢偡傞偐偑壽戣偲側傞丅儅僀僋儘僽儕僢僕宆偺堦偮偺曄宍偲偟偰丄弨暯柺宆偲屇偽傟傞庛寢崌宆偺僕儑僙僼僜儞愙崌偑偁傞俈乯丅恾俆亅侾係偵偦偺柾幃恾傪帵偡丅忋壓俀憌偺挻揱摫懱憌偑愨墢憌傪偼偝傒丄愨墢憌偑業弌偡傞傛偆偵壛岺偝傟偰偄傞丅業弌偟偨愨墢憌忋偵挻揱摫懱偱儅僀僋儘僽儕僢僕傪宍惉偡傞丅弨暯柺宆僕儑僙僼僜儞愙崌偵偍偄偰偼丄儅僀僋儘僽儕僢僕晹暘偺挿偝偼忋壓偺挻揱摫懱憌偵偼偝傑傟偨愨墢憌偺岤偝偵傛傝寛掕偝傟傞偨傔偵惛枾側惂屼偑壜擻偱偁傞丅僕儑僙僼僜儞愙崌偺椪奅揹棳抣偼儅僀僋儘僽儕僢僕晹暘偺抐柺愊丄偡側傢偪暆偲枌岤偵傛傝寛掕偝傟傞丅嵞尰惈偺椙偄椪奅揹棳抣傪摼傞偨傔偵偼偙傟傜傪尩枾偵惂屼偡傞偙偲偑昁梫偲側傞丅偙偺傛偆側弨暯柺宆僕儑僙僼僜儞愙崌偺儅僀僋儘僽儕僢僕嶌惢偵俶倐偺廤懇僀僆儞價乕儉捈愙忲拝枌傪棙梡偡傞偙偲傪帋傒偨丅
丂儅僀僋儘僽儕僢僕晹暘埲奜偼丄俶倐偺僗僷僢僞惉枌丄儕僜僌儔僼傿乕偲斀墳惈僀僆儞僄僢僠儞僌乮Reactive Ion Etching乯偵傛傞僷僞乕僯儞僌丄偍傛傃梲嬌巁壔偵傛傞巁壔憌嶌惢偺岺掱傪慻傒崌傢偣丄恾俆亅侾係偵帵偡傛偆側帋椏傪嶌惢偡傞丅壓晹揹嬌偺岤偝偼栺俁侽侽値倣丄愨墢憌乮俶倐俀俷俆乯偺岤偝偼俁侽乣係侽値倣丄忋晹揹嬌偺岤偝偼栺俀侽侽値倣偱偁傞丅儅僀僋儘僽儕僢僕晹暘偺昁梫偲偝傟傞抐柺愊偼偨偲偊偽侾俁値倣亊俆侽侽値倣掱搙俈乯偱偁傞偑丄儅僀僋儘僽儕僢僕傪嶌惢偡傞晹暘偼妏搙傪帩偭偨抜嵎晹暘偱偁傞偨傔丄暯柺忋偵偍偗傞抐柺愊丄抐柺宍忬傛傝彫偝偔側傞傕偺偲梊憐偝傟傞丅傑偨丄儅僀僋儘僽儕僢僕嶌惢屻偵帋椏傪戝婥拞偵庢傝弌偡偲丄帺慠巁壔偵傛傝嵟昞柺偺俁乣俆値倣偑巁壔憌偵側傞傕偺偲巚傢傟傞丅偟偨偑偭偰丄儅僀僋儘僽儕僢僕晹偺嶌惢忦審偲椪奅揹棳抣偺娭學偼幚尡揑偵媮傔偞傞傪摼側偄丅傑偨丄帺慠巁壔傪杊偖偨傔偵俶倐惉枌偵堷偒懕偒丄俙倳傪敄偔摨偠椞堟偵惉枌偟偰帺慠巁壔偵懳偡傞曐岇枌偲偡傞帋傒傕偍偙側偭偨丅
丂

丂
恾俆亅侾係丏弨暯柺宆僕儑僙僼僜儞愙崌偺峔憿
丂
丂
丂儅僀僋儘僽儕僢僕晹偺惉枌偺慜偵丄忋晹揹嬌偍傛傃壓晹揹嬌偺昞柺偵懚嵼偡傞帺慠巁壔枌傪庢傝彍偔偨傔偵俀侽倠倕倁偺俙倳亄價乕儉偵傛傝丄嵟昞柺悢値倣傪僗僷僢僞僄僢僠儞僌偵傛傝庢傝彍偄偨丅堷偒懕偒丄侾侽侽乣俁侽侽倕倁偺俶倐亄價乕儉偵傛傝儅僀僋儘僽儕僢僕晹傪嶌惢偟偨丅恾俆亅侾俆偵嶌惢偟偨帋椏偺岝妛尠旝嬀憸椺傪帵偡丅俢俠亅俽俻倀俬俢偺僷僞乕儞傪棙梡偟偨帋椏偱偁傞偨傔丄俀僇強偵儅僀僋儘僽儕僢僕傪嶌惢偟偰偄傞丅慄暆乣侽丏俇兪倣丄枌岤乣侾侽値倣偺俶倐僷僞乕儞偵慄暆乣侾兪倣丄枌岤乣侽丏係値倣偺俙倳傪廳偹偰嶌惢偟偨僕儑僙僼僜儞愙崌偺揹棳亅揹埑摿惈偺椺傪恾俆亅侾俇偵帵偡丅揟宆揑側庛寢崌宆偺僸僗僥儕僔僗偺側偄摿惈偑摼傜傟偰偄傞丅椪奅揹棳抣偼係俀兪俙偱偁傞丅傑偨丄儅僀僋儘僽儕僢僕晹暘偼丄挻揱摫懱偺傒側傜偢忢揱摫懱偵傛傝嶌惢偟偰傕嬤愙岠壥偵傛傝庛寢崌偑宍惉偝傟傞偙偲偑抦傜傟偰偄傞俇乯丅俠倳傪梡偄偨儅僀僋儘僽儕僢僕傪嶌惢偟偨偲偙傠丄僕儑僙僼僜儞愙崌偑宍惉偝傟傞偙偲傪妋擣偟偨丅
丂
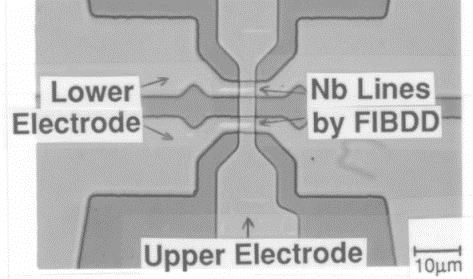
丂
恾俆亅侾俆丏嶌惢偟偨僕儑僙僼僜儞愙崌椺
丂
丂
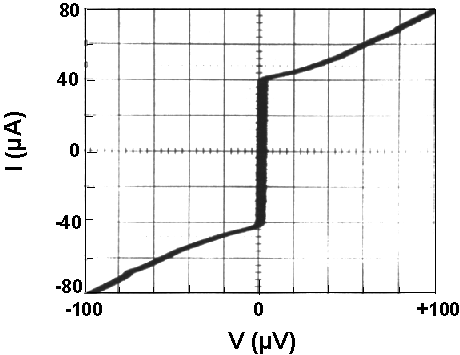
丂
恾俆亅侾俇丏嶌惢偟偨僕儑僙僼僜儞愙崌偺揹棳亅揹埑摿惈椺
丂
丂俽俻倀俬俢偼僕儑僙僼僜儞愙崌傪梡偄偨挻崅姶搙側帴婥僙儞僒乕偱偁傞丅僕儑僙僼僜儞愙崌侾屄傛傝峔惉偝傟傞俙俠亅俽俻倀俬俢偲丄俀屄傛傝峔惉偝傟傞俢俠亅俽俻倀俬俢偑偁傞俉乯丅俢俠亅俽俻倀俬俢偺尨棟偼丄俀屄偺僕儑僙僼僜儞愙崌傪帩偮挻揱摫儕儞僌偵傛傝帴奅亅揹埑偺曄姺傪偍偙側偆偙偲偱偁傞丅椺偊偽恾俆亅侾俇偵帵偟偨僕儑僙僼僜儞愙崌偵傛傝應掕偟偨帴奅亅揹埑摿惈傪恾俆亅侾俈偵帵偡丅墶幉偺侾廃婜偑侾帴婥検巕乮恾拞偵帵偡冇侽乯偵懳墳偡傞丅偙偺俢俠亅俽俻倀俬俢偵傛傝帴椡寁傪峔惉偟丄僲僀僘摿惈傪應掕偟偨丅應掕偵梡偄偨俢俠亅俽俻倀俬俢帴椡寁偺峔惉恾傪恾俆亅侾俉偵帵偡丅偙偺峔惉偼捈愙婣娨曽幃嵎摦宆偲屇偽傟偰偍傝丄専弌僐僀儖偵棳傟傞揹棳傪楇偵偡傞偙偲偵傛傝俀師揑偵敪惗偡傞帴奅傪側偔偡偲偲傕偵丄俽俻倀俬俢儕儞僌偵懳偡傞奜晹帴奅偺塭嬁傪攔彍偡傞偙偲偑偱偒傞丅偙偺帴椡寁偵傛傝應掕偟偨僲僀僘偺僗儁僋僩儖傪恾俆亅侾俋偵帵偡丅偙偺寢壥偼丄儕僜僌儔僼傿乕偺岺掱傪梡偄偰嶌惢偟偨弨暯柺宆僕儑僙僼僜儞愙崌偵傛傞俢俠亅俽俻倀俬俢偲摨摍偺傕偺偱偁傝丄堦斒揑偵嶌惢偝傟偰偄傞僩儞僱儖宆僕儑僙僼僜儞愙崌偵傛傞俢俠亅俽俻倀俬俢偲斾妑偟偰傕懟怓偺側偄傕偺偱偁傞丅
丂偟偐偟丄儅僀僋儘僽儕僢僕晹暘偺惉枌忦審偵懳偡傞椪奅揹棳抣偺嵞尰惈丄惂屼惈偼幚梡椞堟偵偼枹偩払偟偰偄傞偲偼尵偊側偄偨傔丄偙偺庤朄傪僕儑僙僼僜儞愙崌丄俢俠亅俽俻倀俬俢嶌惢偺幚梡揑側庤朄偲偡傞偨傔偵偼丄偝傜偵夵慞偡傞偙偲偑昁梫偱偁傞丅
丂
丂
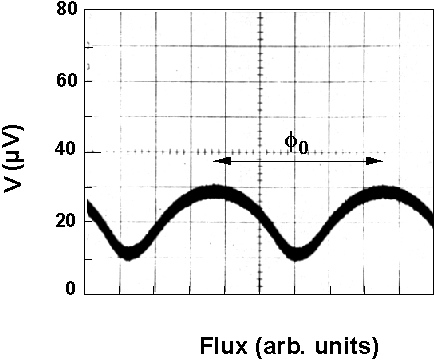
丂
恾俆亅侾俈丏嶌惢偟偨俢俠亅俽俻倀俬俢偺奜晹帴奅亅揹埑摿惈椺
丂
丂

丂
恾俆亅侾俉丏應掕偵梡偄偨俢俠亅俽俻倀俬俢偺峔惉恾
丂

丂
恾俆亅侾俋丏嶌惢偟偨俢俠亅俽俻倀俬俢偺僲僀僘摿惈椺
丂