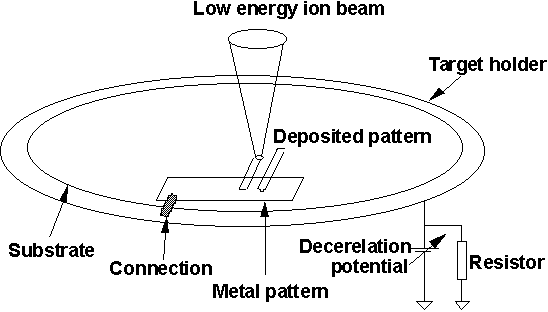
第5章 集束イオンビーム直接蒸着法の応用
5-1.緒言
第4章において、集束イオンビーム直接蒸着膜の基本的な特性について評価をおこない、高純度で実用上充分な特性を持つ導電体、超伝導体として使用できることがわかった。したがって、このような薄膜としての有用性と、微細加工技術としての集束イオンビームの加工特性を併せ持つ集束イオンビーム直接蒸着法は、従来の手法によっては不可能であった加工方法も含めて広範囲な応用を可能にするものと期待することができる。そのような直接蒸着法によってのみ可能となるような応用方法について探索をおこない、候補となったいくつかの応用例について基礎実験を実施し有用性の評価をおこなった。この章においてはそれらの応用方法探索の結果あるいは経過について述べる。
具体的な応用例について述べる前に、ここで集束イオンビーム直接蒸着法の特長をもう一度整理してみる(次節で述べる絶縁物、曲面上への成膜も含む)。
①成膜と同時にパターニングが可能である。
②高純度成膜が可能(バルクに近い特性を持つ)。
③損傷、汚染が生じない。
④自由度の大きな3次元加工が可能である。
⑤エネルギーの調節により蒸着、エッチングを組み合わせた加工が可能である。
⑥複数のイオン種を組み合わせた加工が可能である。
⑦形状、膜厚の制御性が良い。
⑧付着力が強い。
⑨絶縁物上への成膜が可能である。
⑩曲面上への成膜が可能である。
これらの特長を生かした応用例として、回路修正への応用、弾性表面波素子への応用、超伝導量子干渉素子(Superconducting Quantum Interference Device : SQUID)への応用、磁気多層膜への応用および微小試料への電極形成を実用化に発展させる可能性を持つ候補として選択した。上記集束イオンビーム直接蒸着法の特長のうちどの項目がこれらの応用例に生かされているかという関係を表5-1に示す。
表5-1.直接蒸着法の特長と応用例の関係
直接蒸着法の特長 |
応用例 |
①②③④⑤ ⑧⑨_ |
回路修正への応用 |
①②③④⑤⑥⑦⑧⑨_ |
弾性表面波素子への応用 |
①② ⑤ ⑦⑧__ |
SQUIDへの応用 |
①②③④ ⑥⑦⑧__ |
磁気多層膜への応用 |
①②③④ ⑦⑧⑨⑩ |
微小試料への電極形成 |
本章ではまず、集束イオンビーム直接蒸着法の応用を探索するにあたって重要な特性である絶縁物上への蒸着および曲面上への蒸着に関して述べた後、表5-1に示す応用例である、回路修正への応用、弾性表面波素子への応用、SQUIDへの応用、磁気多層膜への応用および微小試料への電極形成について述べる。
5-2.絶縁物上および曲面上への蒸着
5-2-1.絶縁物上への蒸着
イオンビームを絶縁物上に照射すると、絶縁物表面に電荷がたまり電位が上昇する、チャージアップ(charge up)と呼ばれる現象が生じる。低エネルギーのイオンビームの場合にはその影響は顕著であり、上昇した電位が容易にイオンビームの加速電位と同じになるため、イオンビームは絶縁物表面に到達する前に減速され押し戻されるために絶縁物表面に到達できなくなる。この現象はイオンビームを用いたプロセスに特有なものであり、特に低エネルギーイオンビームを利用する場合にその用途を制限するものであった。
集束イオンビーム直接蒸着法においてもいきなり絶縁物に対してビームを照射すると、ビームが到達しないのみならず、基板上に電位の高い部分が分布するために減速電界が影響を受け、電荷が残存する限りビームの位置ずれの原因ともなる。しかし、もし絶縁物基板上に一部でも金属(導電性)のパターンが存在し、パターン部分が基板ホルダーと同電位になるよう電気的に接続されていれば、パターン部分から蒸着を始めて絶縁物上に延長するならば電気的な接続と成膜を同時におこなうことになり、絶縁物上でも成膜することが可能となる。その原理図を図5-1に示す。基本的には蒸着領域の電位は、ビーム電流値と減速電位出力から蒸着領域までの抵抗値の積だけ減速電位出力より上昇する。この値がイオンビームの最終エネルギーに対して無視できる範囲(ビームに決定的な影響をおよぼさない範囲)であれば蒸着をおこなうことができる。導電性のパターンは必ずしも低抵抗である必要はなく、高抵抗あるいは半導体であっても問題はない。ガラス基板上において54eVのAu+ビームを用いて成膜した例を図5-2に示す。ガラス基板上に導電性の塗料を介して基板ホルダーに接続されたNb電極部分があり、その上から蒸着を開始している。このような手法により絶縁物上へ成膜が可能であることを確認した1)。
しかし、この手法がうまく適用できるためには一定の条件が存在する。その条件は、絶縁基板の材質、イオンの種類、エネルギー、蒸着速度、走査速度等の組み合わせにより決まる。後で述べる弾性表面波素子の作製においては、この条件が大きな意味を持つ。このような絶縁物上にうまく成膜できるための条件の存在は、未加工の絶縁物上にビームが初めて走査され、成膜が開始される初期においては、程度の差はあるものの若干のチャージアップは生じていることを示している。そのような初期のチャージアップがビームに影響を与える前に蒸着領域がある抵抗値以内に導通してしまえば、そのまま成膜が継続できるが、初期のチャージアップにより成膜の継続に支障が出るほどの影響が生じた場合(おそらくは導通する前にビーム位置がビーム径以上のずれを生じた場合)には成膜は継続されない。
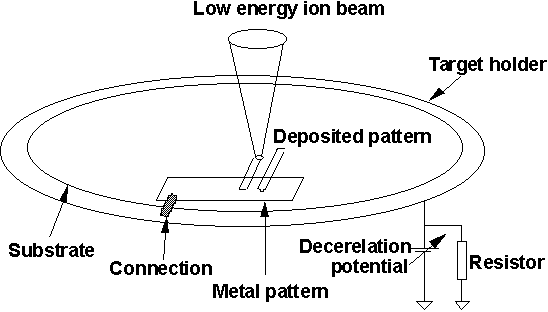
図5-1.絶縁物上への蒸着原理図
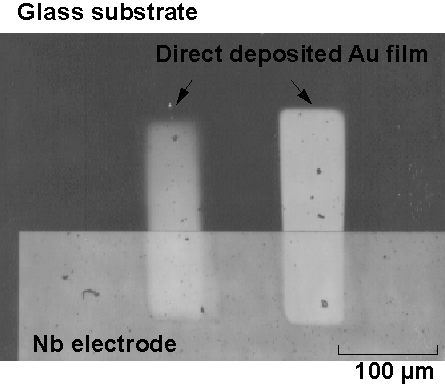
図5-2.絶縁物上への蒸着例
5-2-2.曲面上への蒸着
曲面上への成膜は、減速電界に対する曲面形状の影響がビーム形状を大幅に乱さず、またビーム位置を補正不可能にまで乱さない限り集束イオンビーム直接蒸着法において可能である。したがってリソグラフィーの手法ではパターニングが困難な曲面上においても微細なパターンを作製することが可能である。例として図5-3に市販の直径0.6mmのステンレス製注射針の表面に前処理なしに32eVのAu+およびCu+により微細パターンを成膜した試料の光学顕微鏡写真を示す2)。曲面上への異種金属による微細パターンの成膜はまさに集束イオンビーム直接蒸着法の独壇場であり、医学、生物学関連分野への応用が期待できる。また、基板上に任意の3次元形状の試料が載っている場合にも、試料が充分小さくビーム形状が保存されビーム位置が補正可能である限り、その試料を取り込んだ成膜が可能である。この手法の例とその制限に関しては後の5-7節で述べる。
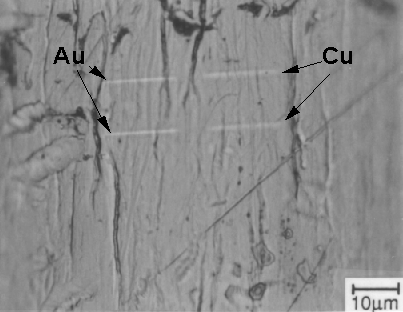
図5-3.曲面上への加工例(光学顕微鏡写真)