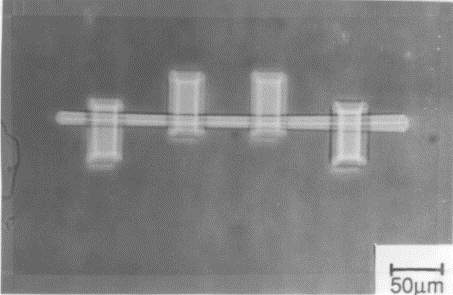
係亅係丏忲拝枌偺揹婥揑摿惈
丂
係亅係亅侾丏掞峈棪偺應掕
丂
丂廤懇僀僆儞價乕儉捈愙忲拝枌偺揹婥揑摿惈偺昡壙偲偟偰丄掞峈棪偺應掕傪偍偙側偭偨丅慜愡偵偍偄偰弎傋偨傛偆偵丄旕忢偵崅弮搙偺惉枌偑壜擻偱偁傞偺偱丄崅弮搙偺僶儖僋嬥懏偵嬤偄抣偑摼傜傟傞傕偺偲梊憐偱偒傞丅掞峈棪偺應掕偵偼丄敿愨墢惈偺俧倎俙倱婎斅傪梡偄丄廤懇僀僆儞價乕儉偵傛傝旐應掕懳徾偱偁傞慄忬偺帋椏傪傑偢惉枌偟丄堷偒懕偄偰扵恓傪摉偰傞偨傔偺係屄偺僷僢僪忬揹嬌傪傕廤懇僀僆儞價乕儉偵傛傝惉枌偟偨丅偙偺傛偆側庤朄偵傛傝丄旐應掕懳徾偲應掕梡偺僷僢僪忬揹嬌傪姰慡偵堦懱偱嶌惢偡傞偙偲偑弌棃傞偺偱丄愙怗掞峈偼慡偔側偔丄偒傢傔偰嵞尰惈偺椙偄應掕偑壜擻偲側偭偨丅
丂恾係亅俉偵丄應掕偵梡偄偨帋椏偺椺傪帵偡丅摨偠婎斅忋偱僄僱儖僊乕偺傒傪曄峏偟偮偮丄暋悢偺帋椏傪嶌惢偟丄忲拝僄僱儖僊乕偑掞峈棪偵偍傛傏偡塭嬁偺昡壙傪偍偙側偭偨丅應掕偼丄俙倳亄丄俠倳亄丄偍傛傃俙倢亄偵偮偄偰偍偙側偭偨丅俙倳亄偺帋椏偼丄慄暆乣侾侽兪倣丄岤偝侽丏侽俉乣侽丏俁俋兪倣丄忲拝僄僱儖僊乕偼俁係乣侾俋係倕倁丄俠倳亄偼慄暆俉乣俋兪倣丄岤偝侽丏侾侽乣侽丏侾俇兪倣丄忲拝僄僱儖僊乕俆係乣侾俋係倕倁丄俙倢亄偼慄暆俈乣侾侾兪倣丄岤偝侽丏侽俉乣侽丏侾侾兪倣丄忲拝僄僱儖僊乕俆係乣俁侾係倕倁偱偁偭偨丅忲拝僄僱儖僊乕偵懳偡傞偙傟傜偺應掕寢壥傪恾係亅俋偵帵偡侾丄俁乯丅忲拝僄僱儖僊乕偑崅偄曽偑丄彮偟掞峈棪偑彫偝偔側偭偰偄傞傛偆偵傕尒偊傞偑丄柧傜偐偱偼側偄丅俙倳偺掞峈棪偼僶儖僋抣乮俀丏係兪兌們倣乯偺侾丏俆乣侾丏俇攞掱搙丄俠倳偺掞峈棪偼僶儖僋抣乮侾丏俈俀兪兌們倣乯偺侾丏俀乣侾丏俆攞掱搙丄俙倢偺掞峈棪偼彮偟戝偒偔僶儖僋抣乮俀丏俈俆兪兌們倣乯偺俀丏俀乣俀丏俈攞偲側偭偰偄傞丅
丂嬥懏偺掞峈棪傪寛掕偡傞偺偼丄奿巕怳摦偵傛傞揹巕嶶棎丄晄弮暔傗寚娮偵傛傞揹巕嶶棎偍傛傃寢徎棻奅傗敄枌昞柺偵偍偗傞揹巕嶶棎偱偁傞丅僶儖僋嬥懏偲斾妑偟偰丄崅弮搙偱偁傞偵傕偐偐傢傜偢掞峈棪偑戝偒偔側偭偰偄傞偺偼丄寢徎棻奅傗寚娮摍偵傛傞揹巕嶶棎偵婲場偡傞傕偺偲巚傢傟傞丅枌岤偵娭偟偰偼丄掞峈棪偵塭嬁傪媦傏偡偲偝傟偰偄傞岤偝乮亙侽丏俉兪倣乯俇乯埲忋偱偁傞偺偱柍帇偱偒傞傕偺偲巚傢傟傞丅寢徎棻奅偵偍偗傞揹巕嶶棎偺塭嬁偼昁偢偟傕掕検揑偵柧傜偐偵偝傟偰偄傞傢偗偱偼側偄偑丄寢徎棻宎偑暯嬒帺桼峴掱偺侾侽攞埲壓偵側傞偲柍帇偱偒側偄塭嬁偑弌傞偙偲偑夝愅揑偵帵偝傟偰偄傞俈乯丅係亅俇愡偵偍偄偰弎傋傞偑丄摟夁揹巕尠旝嬀偵傛傞娤嶡偺寢壥丄俙倳敄枌偺寢徎棻宎偼俁侽乣侾侽侽値倣掱搙偱偁傝俙倳偵偍偗傞帺桼揹巕偺暯嬒帺桼峴掱乮乣俆侽値倣乯俇乯偵嬤偄抣偱偁傞偨傔丄掞峈棪偑憹戝偟偨傕偺偲巚傢傟傞丅俠倳丄俙倢偵娭偟偰傕丄摨條側棟桼偵傛傞傕偺偲巚傢傟傞丅
丂
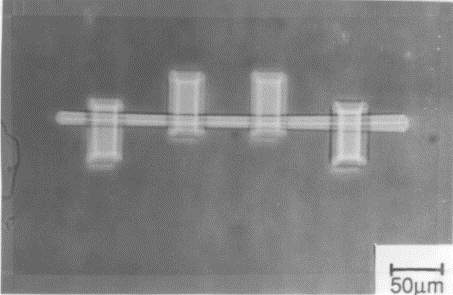
丂
恾係亅俉丏掞峈棪偺應掕偵梡偄偨帋椏椺乮岝妛尠旝嬀幨恀乯
丂

丂
恾係亅俋丏忲拝僄僱儖僊乕偲掞峈棪偺娭學
丂
丂
係亅係亅俀丏僔儑僢僩僉乕愙崌偺嶌惢
丂
丂敿摫懱忋偵嬥懏傪惉枌偡傞偲丄懡偔偺応崌乮巇帠娭悢偺慻傒崌傢偣偵傛傝寛掕偝傟傞乯丄奅柺偵僔儑僢僩僉乕愙崌乮Schottky junction乯偲屇偽傟傞巇帠娭悢偺嵎傛傝惗偠傞僄僱儖僊乕偺忈暻偑宍惉偝傟傞丅惍棳嶌梡偑惗偠傞偨傔丄僟僀僆乕僪傗揹奅岠壥僩儔儞僕僗僞偵梡偄傜傟傞丅廤懇僀僆儞價乕儉捈愙忲拝朄偵傛傝桳岠側僔儑僢僩僉乕愙崌偑宍惉偝傟傞偙偲傪妋擣偡傞偨傔偵丄俧倎俙倱俵俤俽俥俤俿偺僎乕僩揹嬌傪捈愙忲拝朄偵傛傝惉枌偟丄偦偺摿惈傪應掕偟偨丅恾係亅侾侽偵帋椏嶌惢偺庤弴傪帵偡丅敿愨墢惈偺俧倎俙倱忋偵岤偝俀侽侽値倣偺値宆偺妶惈憌傪帩偮婎斅傪儊僒宆偵僄僢僠儞僌偡傞丅師偵丄俙倳乛俶倝乛俙倳亅俧倕傪惉枌偟丄儕僼僩僆僼偵傛傝僜乕僗揹嬌乮source electrode乯偲僪儗僀儞揹嬌乮drain electrode乯傪宍惉偡傞丅師偵壛擬張棟偵傛傝偙傟傜偺揹嬌偲妶惈憌娫偺掞峈惈愙崌乮ohmic contact乯傪宍惉偡傞丅嵟屻偵俆侽倕倁俙倳亄廤懇僀僆儞價乕儉偵傛傝僎乕僩揹嬌乮gate electrode乯傪宍惉偟昡壙偵梡偄傞帋椏傪嶌惢偟偨丅傑偨丄嶲徠梡偲偟偰俙倳乛俿倝偺忲拝偲儕僼僩僆僼偵傛傞僎乕僩揹嬌傪帩偮傕偺偺嶌惢傕偍偙側偭偨丅恾係亅侾侾偵嶌惢偟偨帋椏偺岝妛尠旝嬀憸傪帵偡丅恾係亅侾俀偵應掕偟偨僩儔儞僕僗僞偺摿惈寢壥偺椺傪帵偡丅偙偺寢壥偼嶲徠梡偵嶌惢偟偨帋椏偲傎傏摨偠傕偺偱偁傝丄廤懇僀僆儞價乕儉捈愙忲拝朄偑擻摦揑側慺巕偺嶌惢偵傕桳岠側庤朄偱偁傞偙偲偑柧傜偐偵側偭偨丅
丂
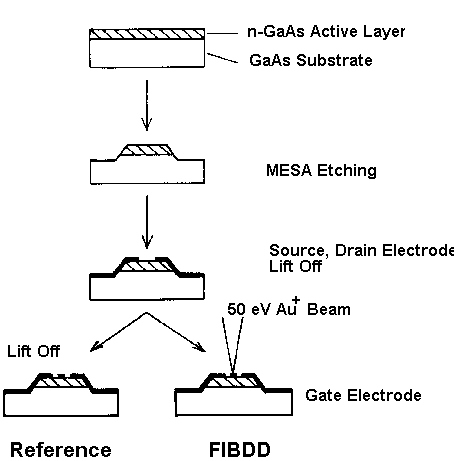
丂
恾係亅侾侽丏俧倎俙倱俵俤俽俥俤俿帋椏嶌惢庤弴
丂
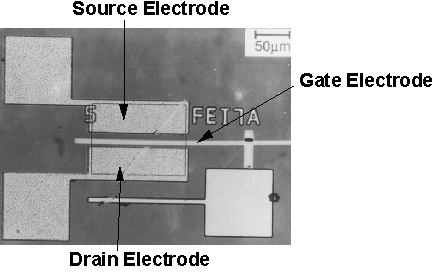
丂
恾係亅侾侾丏俧倎俙倱俵俤俽俥俤俿帋椏椺
丂
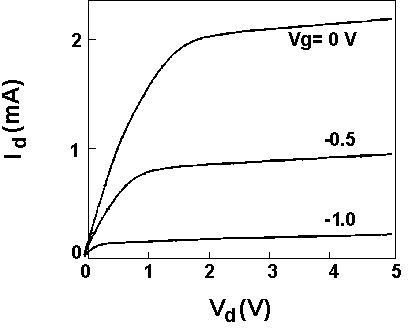
丂
恾係亅侾俀丏僩儔儞僕僗僞摿惈應掕寢壥椺
丂